| 設備 | 対応Wafer | 機能 | |
|---|---|---|---|
加工機 |
CMP装置 ARW-8C1MS | 3インチ〜12インチ(300mm) | - |
| CMP装置 BC-15CN | チップ、2インチ~6インチ(150mm) | 卓上型 | |
| CMP装置 ARW-681MSⅡ | ~8インチ(200mm) | OS2 | |
| 研削装置 GYR-300 | 小片〜12インチ(300mm) | 最大径Φ300mm | |
洗浄機 |
洗浄機 ZAB-8S1M | ~8インチ(200mm) | - |
測定器 |
金属膜厚測定器 | 3インチ〜12インチ(300mm) | - |
| 触針式段差計測器 | 〜8インチ(200mm) | 触針2μm&サブミクロン | |
| 光学顕微鏡 | 4インチ(100mm)、6インチ(150mm)、8インチ(200mm) | - | |
| 光干渉式膜厚測定器 | 〜8インチ(200mm) | - | |
| マイクロスコープ | - | - | |
| LSI検査顕微鏡 | - | - | |
| ハロゲン光源装置 | - | - | |
| ハイトゲージ | 〜12インチ(300mm)付近 | 分解能 0.1μm | |
| 光学顕微鏡 | - | - |
半導体CMP受託加工 / プロセス開発 / 試作
半導体CMP受託加工 / プロセス開発 / 試作
CMPの受託加工サービスでは、CMPのプロセス開発や試作、消耗品評価用加工などをCMP受託加工サービスとして提供しております。
半導体デバイス、SiCパワーデバイス・SOI・マイクロマシン(MEMS)・光学系デバイス、LEDサファイアなど様々な材料に対応します。
また、TSV(Si貫通電極)やTGV(ガラス貫通電極)、ダマシンプロセスなども実績がありますのでご相談ください。
研削装置・CMP装置、 ポストCMP洗浄装置、 精密研磨(ラップ・ポリッシュ) の受託加工サービス、消耗品を取り扱っていますので、お客様の「平坦化」「平滑化」「薄化(薄膜化)」といったニーズに応じて「研削」「ラッピング」「ポリッシング」「CMP」「洗浄」等、確かな技術力と長年積み重ねたノウハウを元に、装置・消耗品・プロセス・レシピが一体となったトータルソリューションとしてご提案します。
CMPとは
CMPとは、半導体ウェーハやデバイスの研磨に使われる言葉で、Chemical…化学的、Mechanical…機械的、Planarization…研磨の略、化学的作用と機械的作用を併用して研磨することです。
研磨パッドに研磨スラリーを滴下し、研磨ヘッドに取り付けた加工物に力を与え、表面を研磨します。
主にベアウェーハのÅ(オングストローム)レベルの鏡面化やデバイス基板の平坦化、配線材の埋め込みなどで採用される研磨手法です。
ベアウェーハの原料はシリコンが主流ですが、ここ数年では、セラミクスやSiC、GaNといったそれ以外の材料の需要も増えています。デバイスウェーハでは微細化および積層化が進んでおり、より精密なCMPが求められています。
CMP装置の主要部とCMPに必要な材料・消耗品

CMPプロセス開発 / 試作 / 請負加工

当社では、CMP加工の他に、研削加工やポストCMP洗浄も受託加工サービスとして対応しています。
受託請負プロセスフロー

CMP加工例
-

トレンチへの埋め込み平坦化、ダマシンプロセス
埋め込み配線等を形成するプロセスの中で不要な膜をCMPにて除去します。
金属等膜材料: Au、Cu、Ti、樹脂、PSG、P-Si(ポリマー、PR等)
絶縁膜材料: TaN、TiN
基板: Si、PSGi、セラミック、樹脂、ガラス -
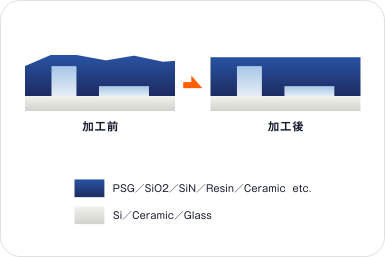
初期段差・層間膜の平坦化
多層配線を行う半導体製造において、段差や層間膜の高精度な平坦化は必要不可欠です。
膜材料: PGS、SiO2、SiN、樹脂、セラミック等
基板: Si、セラミック、ガラス -

貫通メタル配線:TSV(シリコン貫通電極)、TGV(ガラス貫通電極)の平坦化
基板に形成されたビアに金属が充填された表面を平坦化することで、高密度実装を実現します。
材料: Cu等
基板: Si、セラミック、ガラス等 -

面粗さの向上
均一で極めて滑らかな面にすることで、高精度な製品製造を可能にします。
材料:Cu、SiO2、SiN等
基板:Si、セラミック、ガラス等